-
 宽域变温扫描MDP-PICTS技术革新半导体质控的三大核心突破在光伏与微电子产业高速发展的今天,半导体材料的质量控制已成为决定产品良率与成本的核心要素。传统电学表征技术因需接触式电极制备,存在破坏样品、空间分辨率低、难以适应产线节奏等痛点。FreibergInstruments公司凭借其革命性的微波检测技术——微波探测光导率(MDP)与微波探测光诱导电流瞬态谱(MDPICTS),正在全球半导体材料分析领域掀起技术革新浪潮。一、技术
宽域变温扫描MDP-PICTS技术革新半导体质控的三大核心突破在光伏与微电子产业高速发展的今天,半导体材料的质量控制已成为决定产品良率与成本的核心要素。传统电学表征技术因需接触式电极制备,存在破坏样品、空间分辨率低、难以适应产线节奏等痛点。FreibergInstruments公司凭借其革命性的微波检测技术——微波探测光导率(MDP)与微波探测光诱导电流瞬态谱(MDPICTS),正在全球半导体材料分析领域掀起技术革新浪潮。一、技术 -
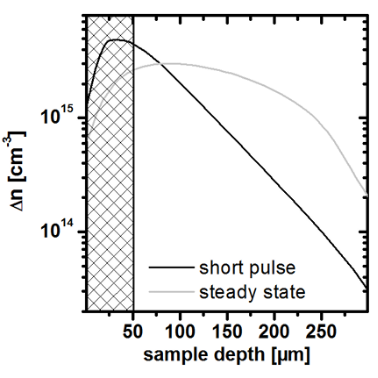 基于深度分辨光电导法的半导体缺陷检测---Freiberg Instruments MDP技术随着半导体器件结构向多层化、薄层化发展,传统载流子寿命检测技术已难以满足精度需求。固定激发深度的测量方法无法区分表面重组效应与体材料/界面缺陷,导致工艺优化缺乏针对性指导。FreibergInstruments公司在相关期刊发表的突破性研究表明,其新型微波检测光电导率系统(MDP)通过可编程脉冲激光激发与深度关联算法,首次实现5-300μm范围内缺陷分布的三维可视化(图1)。图1.厚度为
基于深度分辨光电导法的半导体缺陷检测---Freiberg Instruments MDP技术随着半导体器件结构向多层化、薄层化发展,传统载流子寿命检测技术已难以满足精度需求。固定激发深度的测量方法无法区分表面重组效应与体材料/界面缺陷,导致工艺优化缺乏针对性指导。FreibergInstruments公司在相关期刊发表的突破性研究表明,其新型微波检测光电导率系统(MDP)通过可编程脉冲激光激发与深度关联算法,首次实现5-300μm范围内缺陷分布的三维可视化(图1)。图1.厚度为 -
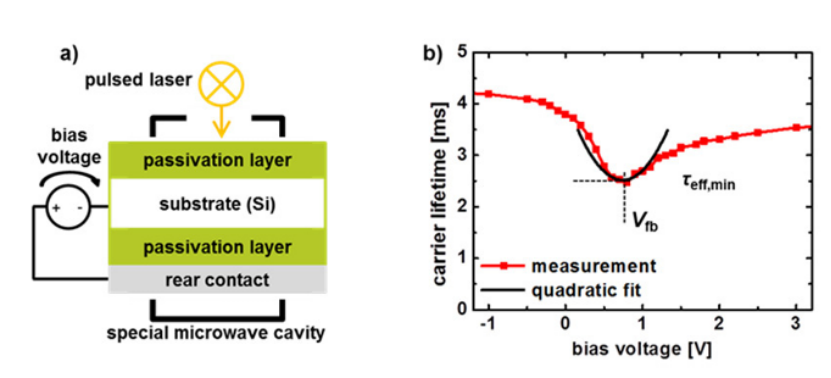 BiasMDP 技术搭配MDPmap设备---开启表面钝化检测新方式在能源产业蓬勃发展的当下,追求更高效率的太阳能电池成为行业核心目标。而这其中,表面钝化技术的优劣起着决定性作用。要深入理解和优化表面钝化,精准测量固定电荷和界面缺陷密度这两个关键参数至关重要。为大家介绍一项引领行业变革的创新技术——基于微波探测光电导衰减法(MDP)的BiasMDP技术,这一技术在实验测量环节,FreibergInstruments公司的MDPmap型号
BiasMDP 技术搭配MDPmap设备---开启表面钝化检测新方式在能源产业蓬勃发展的当下,追求更高效率的太阳能电池成为行业核心目标。而这其中,表面钝化技术的优劣起着决定性作用。要深入理解和优化表面钝化,精准测量固定电荷和界面缺陷密度这两个关键参数至关重要。为大家介绍一项引领行业变革的创新技术——基于微波探测光电导衰减法(MDP)的BiasMDP技术,这一技术在实验测量环节,FreibergInstruments公司的MDPmap型号 -
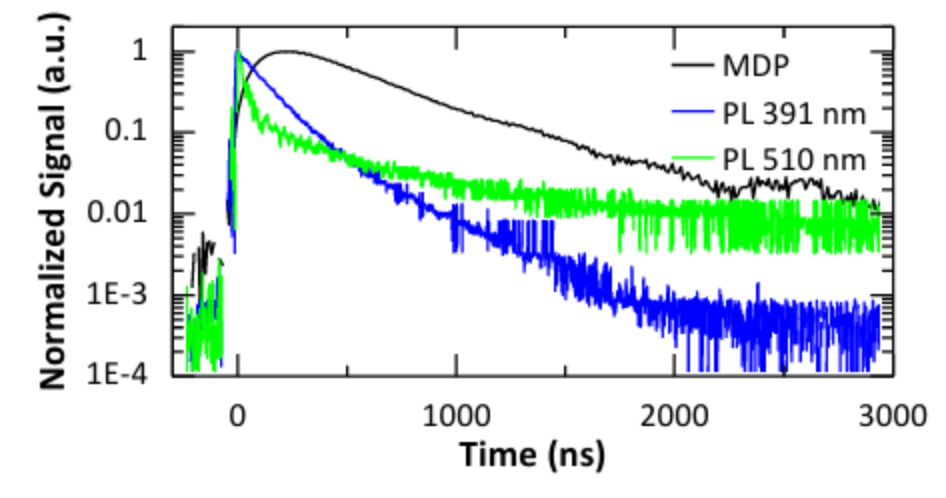 解锁4H-SiC外延片潜力-MDP 技术的突破性应用在半导体器件性能参数中,少数载流子寿命占据核心地位,尤其在SiC应用于高压器件时,其对整体性能起着决定性作用。通过控制载流子寿命,能显著提升器件在不同场景下的表现。然而,4H-SiC外延层中,载流子寿命受多种复杂因素制约,外延层表面、与衬底的界面、外延层自身以及衬底都会影响载流子复合。同时,测量条件的差异,如激发波长和强度的变化,也会干扰有效载流子寿命的准确测定。这使得精准把握载流子寿命变得极
解锁4H-SiC外延片潜力-MDP 技术的突破性应用在半导体器件性能参数中,少数载流子寿命占据核心地位,尤其在SiC应用于高压器件时,其对整体性能起着决定性作用。通过控制载流子寿命,能显著提升器件在不同场景下的表现。然而,4H-SiC外延层中,载流子寿命受多种复杂因素制约,外延层表面、与衬底的界面、外延层自身以及衬底都会影响载流子复合。同时,测量条件的差异,如激发波长和强度的变化,也会干扰有效载流子寿命的准确测定。这使得精准把握载流子寿命变得极 -
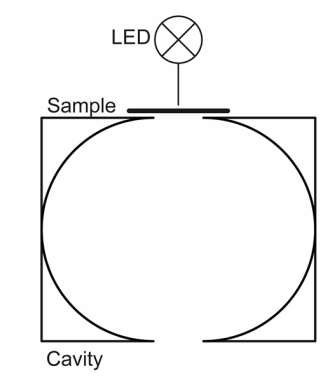 深能级缺陷表征-MDPICTS在半导体材料的研究与应用中,缺陷表征至关重要。特别是在中子嬗变掺杂(NTD)硅的处理过程中,了解其辐射诱导缺陷对于优化退火条件、提升材料性能意义非凡。FreibergInstruments公司的微波探测光致电流瞬态光谱法(MDPICTS)技术(如图1),为这一领域带来了新的突破,展现出诸多传统技术难以企及的优点。NTD硅,因能实现极低的电阻率变化,在大面积辐射探测器制造中占据重要地位。然而,掺
深能级缺陷表征-MDPICTS在半导体材料的研究与应用中,缺陷表征至关重要。特别是在中子嬗变掺杂(NTD)硅的处理过程中,了解其辐射诱导缺陷对于优化退火条件、提升材料性能意义非凡。FreibergInstruments公司的微波探测光致电流瞬态光谱法(MDPICTS)技术(如图1),为这一领域带来了新的突破,展现出诸多传统技术难以企及的优点。NTD硅,因能实现极低的电阻率变化,在大面积辐射探测器制造中占据重要地位。然而,掺 -
 少数载流子寿命测试仪测定硅片中的铁浓度铁含量的准确测定是非常重要的,因为铁是硅中含量最丰富也是最有害的缺陷之一。因此,有必要尽可能准确和快速地测量铁浓度,并具有非常高的分辨率,最好是在线测量。使用德国FreibergMDPingot和MDPmap系列,可以全自动测量晶锭和晶片中的铁浓度,并具有高分辨率。铁硼对解离前后的寿命测量是硅片铁含量测定中广泛应用的方法。在高掺杂浓度的硼掺杂硅中,当它用于光伏应用时,几乎100%的电活性铁以F
少数载流子寿命测试仪测定硅片中的铁浓度铁含量的准确测定是非常重要的,因为铁是硅中含量最丰富也是最有害的缺陷之一。因此,有必要尽可能准确和快速地测量铁浓度,并具有非常高的分辨率,最好是在线测量。使用德国FreibergMDPingot和MDPmap系列,可以全自动测量晶锭和晶片中的铁浓度,并具有高分辨率。铁硼对解离前后的寿命测量是硅片铁含量测定中广泛应用的方法。在高掺杂浓度的硼掺杂硅中,当它用于光伏应用时,几乎100%的电活性铁以F -
 德国Freiberg少子寿命测试仪微波检测到的光电导率德国FreibergMDP非常适合以下两种方法,一是通过测量取决于注入量的少数载流子寿命来进行缺陷调查,二是用于在线测量的晶圆甚至晶锭的图形化。它在灵敏度、分辨率和速度方面超过了µPCD(微波检测光导衰减)和QSSPC(准稳态光导)。利用矩形激光脉冲激发前后的微波吸收,测量了与扩散长度密切相关的光电导率。图1显示了德国FreibergMDP和MD-PICTS测量的测量原理。图1.能
德国Freiberg少子寿命测试仪微波检测到的光电导率德国FreibergMDP非常适合以下两种方法,一是通过测量取决于注入量的少数载流子寿命来进行缺陷调查,二是用于在线测量的晶圆甚至晶锭的图形化。它在灵敏度、分辨率和速度方面超过了µPCD(微波检测光导衰减)和QSSPC(准稳态光导)。利用矩形激光脉冲激发前后的微波吸收,测量了与扩散长度密切相关的光电导率。图1显示了德国FreibergMDP和MD-PICTS测量的测量原理。图1.能 -
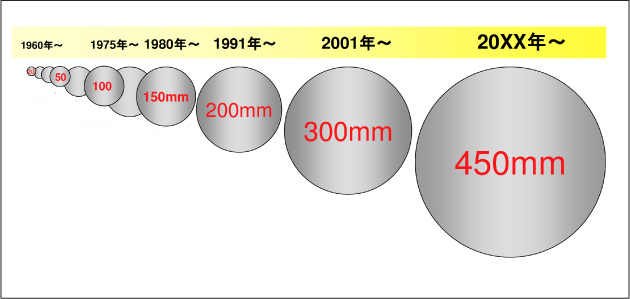 半导体18英寸晶圆片的少数载流子寿命图几年来,微电子行业正计划将晶圆片直径从300毫米(12英寸)扩大到450毫米(18英寸),以获得更高的成品率。现在已经有了生产这种高质量晶圆片的技术,但只有调整晶圆厂的成本问题,仍然无法转移到更大的晶圆尺寸。这些450毫米晶圆片还需要检查外部和内部杂质,因此需要高度空间分辨寿命测量。在与FraunhoferIISB的合作中,FreibergInstruments在EC资助的SEA4KET项目中
半导体18英寸晶圆片的少数载流子寿命图几年来,微电子行业正计划将晶圆片直径从300毫米(12英寸)扩大到450毫米(18英寸),以获得更高的成品率。现在已经有了生产这种高质量晶圆片的技术,但只有调整晶圆厂的成本问题,仍然无法转移到更大的晶圆尺寸。这些450毫米晶圆片还需要检查外部和内部杂质,因此需要高度空间分辨寿命测量。在与FraunhoferIISB的合作中,FreibergInstruments在EC资助的SEA4KET项目中

