半导体晶圆片和晶锭的电阻率测量
电阻率是材料最重要的电参数之一。它是半导体器件(如太阳能电池)性能的关键参数,并取决于材料的掺杂密度。因此,为了检测掺杂密度的不均匀性,需要对电阻率进行高精度、高分辨率的测量。

使用德国freiberg MDPmap和MDPingot,可以通过涡流测量高精度和分辨率为1毫米的方式来测量晶圆片或晶块的电阻率。由于距离相关的内部校准矩阵,涡流传感器有一个非常好的长期稳定性。因此,每一个电阻率图都是测量表面平坦度的几何图。电阻率可与少数载流子寿命和光电导率图同时测量。在进行晶圆测量时,需要用户提供样品的厚度。
l步径≥1mm
l边缘:12mm
l电阻率片厚度:150-250µm
l可指定电阻率范围
l默认设置:0.5-5 Ohm cm
l准确度:< 5%
l重复性:< 1%(范围从0.5-3 Ohm cm)
为了研究发射极扩散的均匀性,有可能绘制出发射极的方阻。基础的电阻率由用户给出。
l方阻测量范围是0.1-200 Ohm/sq。
l在标准样本量下的准确度,
l0.1-10 Ohm/sq: < 3 % accuracy
l10-100 Ohm/sq: < 4 % accuracy
l100-200 Ohm/sq: < 5 % accuracy
图1 - 3显示了在mc-Si晶圆片和硅块上测量的电阻率图。
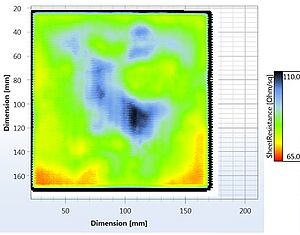
图1.典型mc-Si晶片的发射极方阻图,平均方阻值为85.1 Ohm/sq
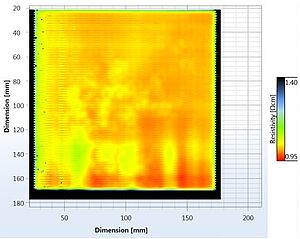
图2.用于光伏应用的典型mc-Si晶片的电阻率图,平均电阻率为1.0 Ohm cm
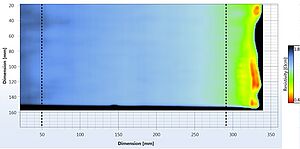
图3.用于PV应用的典型mc-Si砖的电阻率图,平均电阻率为1.4 Ohm cm


