MDpicts 温度依赖型寿命测试系统

MDpicts
温度依赖型寿命测试系统
MDpicts温度依赖型寿命测试系统该设备可对材料电学特性进行非接触、无损伤的单点测量。总体而言,MD-PICTS设备适用于多种材料及不同制备阶段的测量,涵盖硅原料、裸片、各类中间制备阶段样品,以及砷化镓(GaAs)、磷化铟(InP)等化合物半导体。该系统可检测电阻率高于 0.3Ωcm的单晶硅与多晶硅,核心聚焦缺陷、少子寿命及光电导的温度依赖型测量,同时可检测硅中的污染物及电活性晶体中的缺陷,具备微波光电导衰减瞬态(μPCD)和稳态(MDP)测量功能。
碲镉汞|碳化硅 | 化合物半导体 | 氧化物 | 宽带隙材料 | 钙钛矿| 外延层
[ HgCdTe | SiC | InP | ZnS | CdTe | GaAs | GaN | Ge ]and more
核心优势:
赋能材料缺陷根源分析:无损伤、高灵活、高精度
采用斯特林制冷器(Stirling refrigerator)冷却,无需操作液氮
针对各类材料的定制化激光与光学集成方案
全自动温度依赖型测量
MDpicts可覆盖几乎所有半导体材料的电学特性表征
技术规格
| 变温范围 | 50 ~ 300K |
| 样品尺寸 | 最大 20 x 20 mm晶圆片 |
| 电阻率 | > 0.3 Ohm cm |
| 导电类型 | P型、N型 |
| 少子寿命范围 | 20 ns – 100 ms |
| 可检测性能 | 寿命、光电导率、活化能等 |
| 激发 | 355 – 1550 nm |
| 软件功能: | 瞬态数据可视化、温度依赖关系可视化,适用时支持峰值分析(含激活能、俘获截面计算)、数据导出功能、打印菜单等功能 |
| 注:本产品所有信息可能会根据最新的研究和开发进行技术更改,恕不另行通知。 | |
应用案例:
光电导测量与陷阱态分析
弗莱贝格仪器(Freiberg Instruments)的MDPmap与MDpicts系统,配备355nm激光器(适配瞬态微波光电导衰减法μ-PCD)或375nm激光二极管(适配稳态微波光电导法MDP),适用于宽带隙氮化物半导体的光电导测量与陷阱态分析。n 型掺杂的均匀性可通过光电导信号(信号强度)进行分析,该信号与材料的电阻率及载流子寿命密切相关。
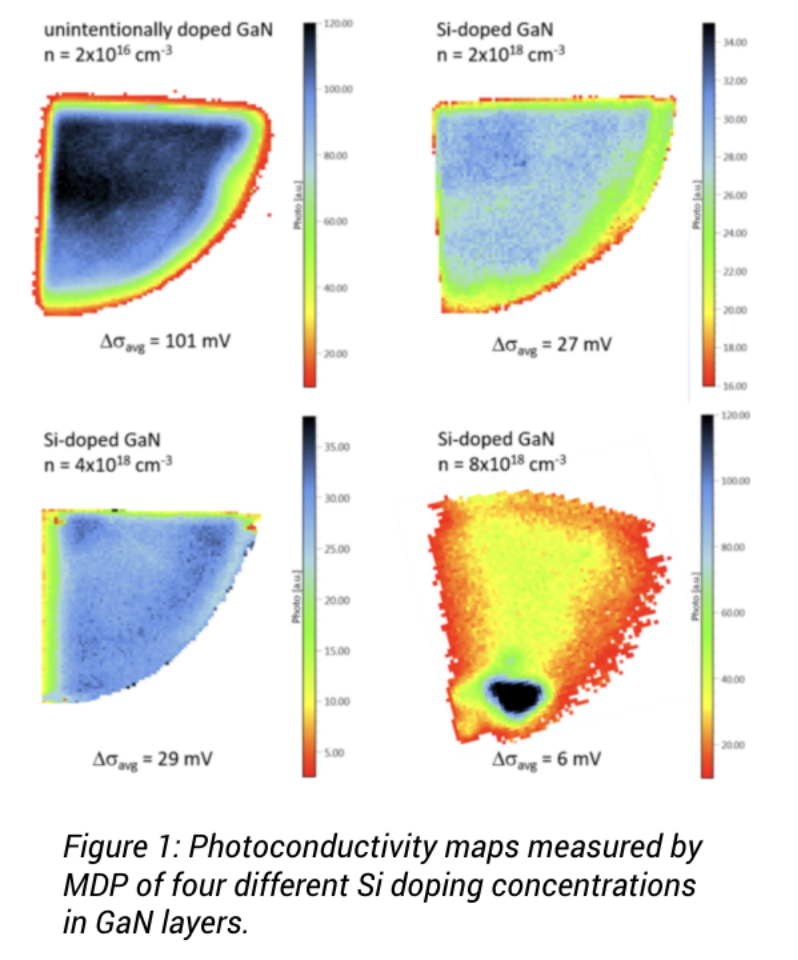
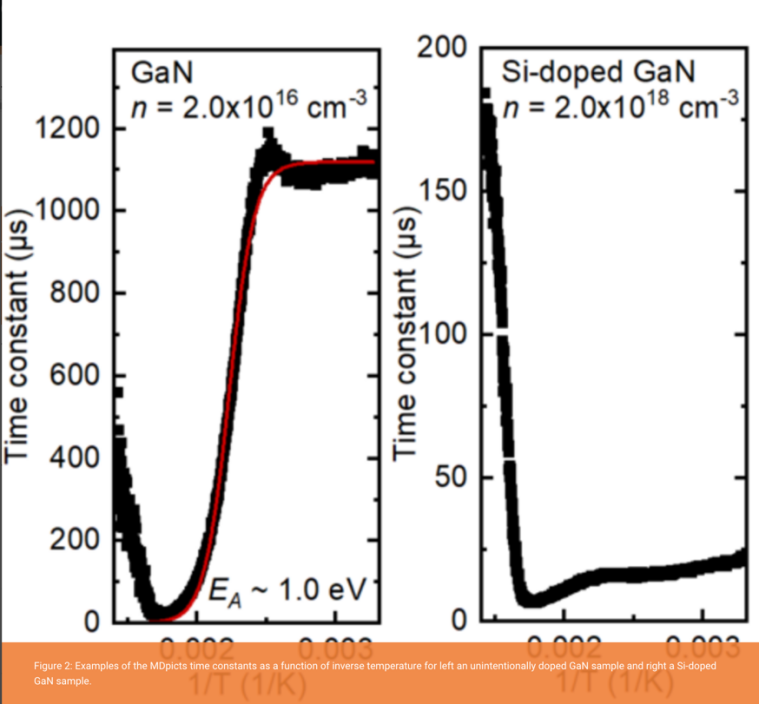
微波探测光致电流瞬态谱(MD-PICTS)
在半导体缺陷研究中,温度依赖型方法的应用极为广泛,例如深能级瞬态谱(DLTS)。

 碳化硅(SiC)的少子寿命测量
碳化硅(SiC)的少子寿命测量近年来,碳化硅(SiC)材料的质量已取得很大的进步,因此在大功率器件等应用场景中,碳化硅正日益成为硅(Si)材料的有力竞争者。作为宽带隙半导体,SiC相较于硅具有诸多优势。少子寿命是影响半导体器件性能的核心参数之一,尤其对于SiC在高压器件中的应用而言至关重要。因此,有必要通过寿命工程优化,使特定器件实现最佳性能。为了以最高良率制造碳化硅器件,不仅需要高分辨率的材料表征技术,还需借助相关方法探究SiC中的缺陷根源,从而进一步提升材料质量。