HTpicts-高温少子寿命测量系统
 HTpicts
HTpicts高温少子寿命测量系统
HTpicts专用于宽禁带半导体中的少子寿命和深能级缺陷检测,用于宽禁带材料在高温区间的非接触、无损伤的温度依赖型测量,涵盖少子寿命、电学特性表征及深能级缺陷研究。(涵盖瞬态模式μPCD、稳态模式MDP、微波光电导等方法,符合SEMI PV9-1110 半导体标准)
碳化硅 |氧化镓|氮化铝 | 氮化镓|金刚石|等
[ SiC |Ga₂O₃|AIN | GaN | Diamond ]and more
核心优势:
专用于宽禁带和超宽禁带材料深能级缺陷测量
深能级缺陷研究的高温条件
针对各类材料的定制化激光集成方案
全自动温度调节测量
技术规格
| 变温范围 | 300 ~ 800K |
| 样品尺寸 | 最大20 x 20 mm晶圆片 |
| 电阻率 | ≥0.3 Ohm cm |
| 导电类型 | P型、N型 |
| 少子寿命范围 | 20 ns – 100 ms |
| 可检测性能 | 寿命、光电导率、活化能等 |
| 激发 | 355 – 1550 nm |
| 软件功能: | 瞬态数据可视化、温度依赖关系可视化,支持峰值分析(含激活能、俘获截面计算)、数据导出功能、打印菜单等功能 |
| 注:本产品所有信息可能会根据最新的研究和开发进行技术更改,恕不另行通知。 | |
应用案例:
磷化铟(InP)中缺陷能级的研究
微波探测光电导瞬态谱(HT-PICTS)是表征磷化铟中缺陷能级的理想方法。例如,针对磷化铟(InP)的研究表明,退火过程会改变材料中的缺陷浓度,而这一变化或许会对其电性能分布产生影响。
未处理样品的缺陷浓度取决于其在晶体中的位置,而晶圆退火处理后的样品则呈现出一组统一的缺陷能级。图1对比了取自晶体不同位置的掺杂铁元素半绝缘磷化铟样品,这些样品的特征缺陷能级存在差异。含铁磷化铟样品中观测到的特征谱峰,首次证实了铁在磷化铟中可作为复合中心发挥作用。
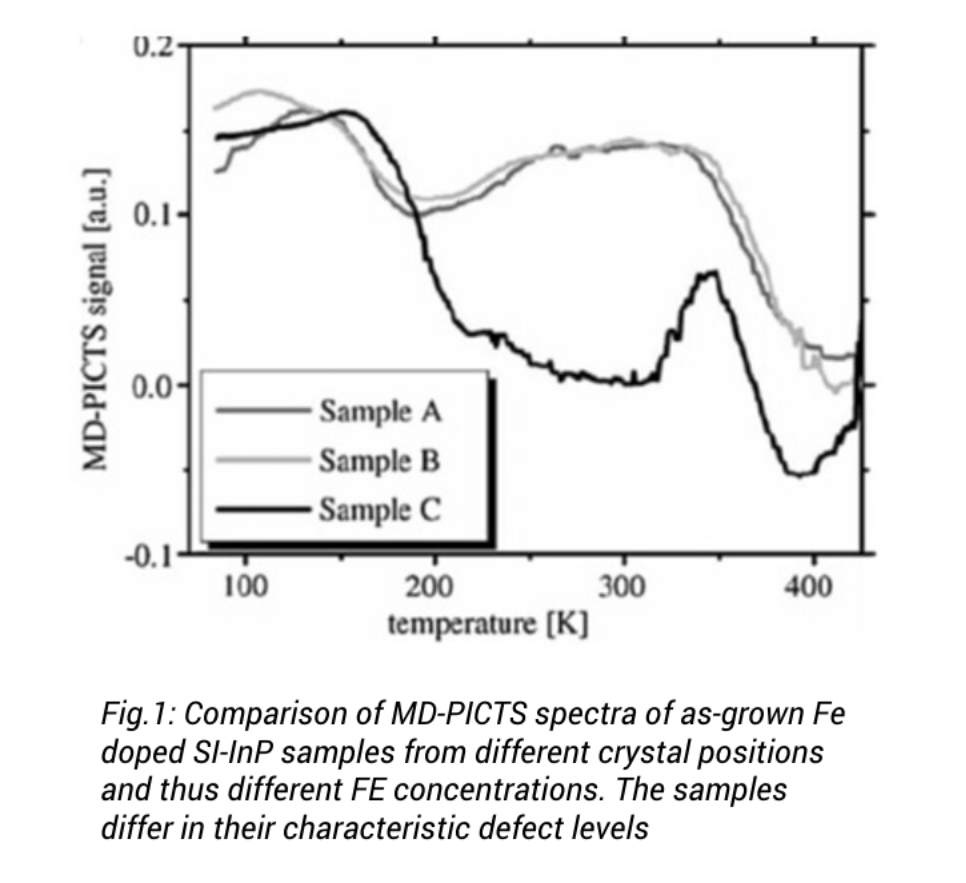 微波探测光致电流瞬态谱(MD-PICTS)
微波探测光致电流瞬态谱(MD-PICTS)用于研究半导体中的缺陷,温度依赖型方法(类似深能级瞬态谱-DLTS)已被广泛应用。